- 上一篇:滚动轴承故障诊断实验平台设计
- 下一篇:电动玩具汽车底板设计及注塑模具设计
1.1.1三级微电子封装
自从大规模电子集成电路成为现实,BGA封装就通常可分成三级封装,如图 1-1 所示。一级封装是将各种不同的材料(陶瓷、金属、塑料等)封装成单个或单个以上的芯片组件,形成一个具有I/O引线的封装。第一步需要将晶粒分割成小块;第二步是将分割好的晶粒粘到基板上;第三步需要把线打在晶粒和基板之间;第四步进行封膜;最后植球。一级封装也被称为芯片级封装,其中就包括单芯片组件(SCM)和多芯片组件(MCM)。由于BGA微电子封装产品向小巧型、轻便化、多平台互动方向的发展,在BGA电子封装领域中,一级封装形式逐渐形成了一股不可阻挡的研究热。二级微电子封装技术的基本概念是把原始的一些零件以及一级电子封装产品安装在集成电路板(PCB)或上下基板上,并最终形成具有一定能力的组件或模型的过程。三级微电子封装技术是这个完整部件或组件的最后安装步骤。由于在完成三级封装之后,就可以产生拥有完整功能的系统,所以它又称为系统级封装。
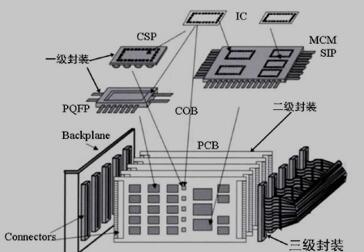
图1-1 三级微电子封装的结构示意图
1.1.2 BGA电子封装
在1989年,美国Motorola公司开发出了世界上第一个BGA(Ball Grid Array)新型封装技术。BGA封装采用平面阵列的排列模式将电路板上的焊球连接传入传出信号,与传统电子封装相比,这种新型的封装技术能大大提高I/O的接口数目。随后Intel公司对这项技术进行了改善,并将它应用到了为电子领域,即为后来的BGA(球栅阵列)封装。按照基板材料与属性分,BGA封装可分为塑料焊球阵列封装(PBGA)、陶瓷焊球阵列封装(CBGA)、金属焊球阵列封装(MBGA)以及倒装芯片焊球阵列封(Flip-Chip BGA,简称FCBGA)。随着BGA 封装在不同领域的广泛应用,人们的生活水平得到了极大地改善。在通讯设备方面,BGA封装技术极大地增加了在I/O引脚的数目上,这使得各个通讯设备之间的信号强度增大,通讯距离变得更远,而且能保证信号不会由于距离的变远或其他因素的干扰而出现失真或延迟的现象。如图1-2的BGA封装示意图所示,它主要由芯片、焊球、铜垫、基板、EMC、粘结层等构成。随着计算机与通讯设备技术的高速发展,不管是外观还是性能都得到了极大的提升,而且轻巧化和可携性也是现代人们所追求的时尚,这便导致了BGA封装技术越来越向着小型、轻便以及高性能的方向发展。同时,BGA封装兼备引线电感和电容小,高密度封装,废品率低,成本低廉等优点而受到了大家的欢迎。